碳化硅的激光切割技術介紹
發布日期:2025-01-03 10:36 ????瀏覽量:
在半導體制造中,晶片切割是至關重要的一環。切割方式和質量直接影響晶片的厚度、粗糙度、尺寸及生產成本,進而對器件制造產生重大影響。碳化硅(SiC)作為第三代半導體材料,因其優異的電氣特性而備受關注。但由于其極高的硬度和脆性,傳統切割方法難以滿足日益增長的工業需求。因此,研究和開發新型切割技術顯得尤為重要。
碳化硅的莫氏硬度達到9.5級,緊隨金剛石之后,使得其在切割過程中面臨諸多挑戰。傳統的砂漿線切割和金剛石線鋸切割方法雖然可以用于切割碳化硅晶錠,但切割效率低、材料損失高達46%,且切口粗糙,增加了生產成本。因此,尋找更高效、低損耗的切割技術成為行業發展的迫切需求。
近年來,激光切割技術在半導體材料的加工中逐漸受到重視。這種非接觸式工藝通過聚焦激光束進行材料分離,避免了刀具磨損和機械應力的影響。激光切割不僅提高了晶圓的表面粗糙度和精度,還減少了后續拋光的需求,降低了材料損失和生產成本。激光切割技術早已經應用于硅晶錠的切割,但在碳化硅領域的應用還未成熟,目前主要有以下幾項技術。
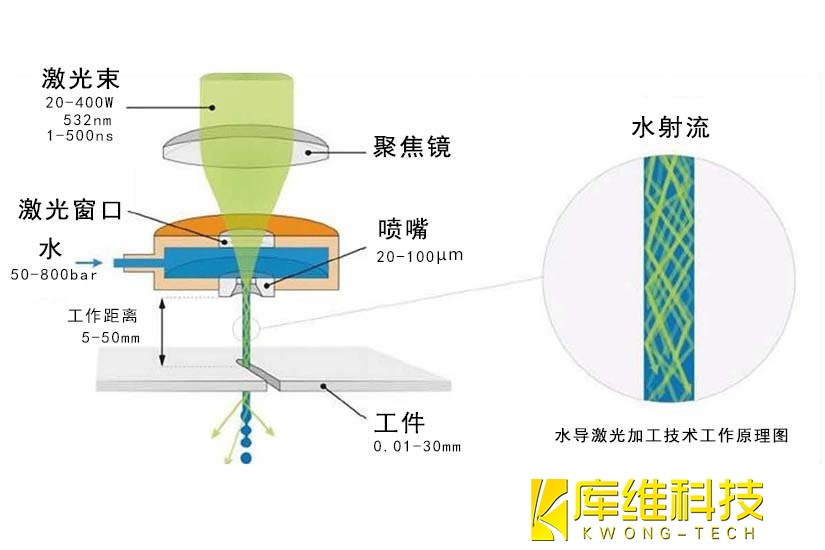
原理:利用激光通過壓力調制的水腔,將激光束聚焦在噴嘴上,形成光波導,從而引導激光切割。
優勢:切割質量高,水流能有效冷卻切割區,降低熱損傷,且能帶走加工碎屑,速度明顯快于傳統方法。
發展現狀:瑞士Synova公司在該領域處于技術領先地位,國內企業如庫維激光正在積極研發。
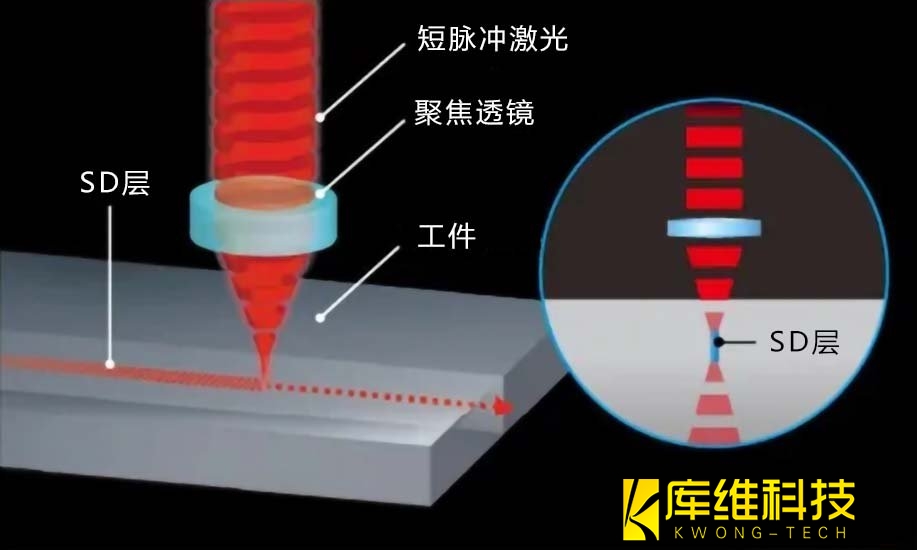
2、隱形切割
原理:激光透過碳化硅表面聚焦至內部,形成改性層以實現剝離。
優勢:表面無切口,能實現較高的加工精度。
技術進展:日本DISCO公司的KABRA技術通過無定形黑色重復吸收,顯著提高了生產率。

3、冷切割技術
原理:利用激光照射形成剝落層,產生微裂紋,隨后通過聚合物冷卻處理形成主裂紋。
優勢:材料損失低至80μm,降低了90%的材料浪費,生產成本降低30%。
評估結果:分割后的晶圓表面粗糙度小于3µm,最佳結果小于2µm。

4、改質切割
原理:通過精密激光束掃描形成改質層,使晶圓可通過外加應力沿激光路徑拓展。
應用:該技術已被國內激光企業應用于實際生產中。
當下,國內廠商已經掌握砂漿切割碳化硅技術,但砂漿切割損耗大、效率低、污染嚴重,正逐漸被金剛線切割技術迭代。而激光切割憑借高效、劃片路徑窄、切屑密度高等優勢,是取代金剛線切割技術的有力競爭者,為碳化硅等下一代半導體材料的應用開辟了一條新途徑。隨著碳化硅襯底尺寸持續增大,激光切割技術必將乘風破浪,引領未來碳化硅切割走向高效、高質量的新征途,為半導體行業注入澎湃動力。
相關文章

激光切割機為何發展如此迅速

激光切割中不同顏色的激光有什么區別?

2024年激光切割技術的最新趨勢

水導激光加工在碳化硅材料上的實際應用
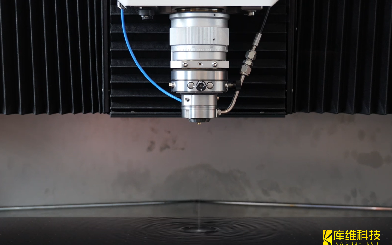
水導激光技術在國際領域的研究進展

不同梯度的金屬材料適合的切割技術

水導激光加工在微電子制造中的應用

水導激光切割在玻璃纖維增強復合材料上的應用

水導激光切割在鋁合金上的應用